投诉热线:13148701893
联系人:邓小姐
传真:0755-27315661
0760-85884496
座机:0755-29769890-0
0760-85884486
办公地址:深圳市宝安区福永塘尾富华工业区11栋3楼
工厂地址:广东省中山市三乡镇万里路1号平铺工业区B栋三楼

目前手机显示主要采用COG技术进行驱动芯片的封装。18:9显示屏仍然可以采 用COG工艺,但是未来几年随着全面屏从18:9向19:9甚至20:9演进,COG将越发力不从心。而采用COF的全面屏,其下端边框可能缩小至3.6mm的距离甚至更小,因此COF将满足更高屏占比的需求。
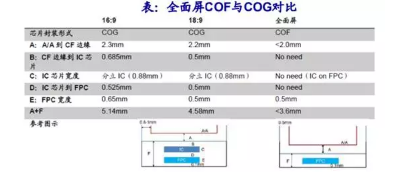
对于全面屏而言,最佳的方式是基于COF工艺(即触控IC固定于FPC软板上), 相比于COG可以进一步提升显示面积。根据台湾工研院的研究数据,尽管采用 COF的1:6 MUX TDDI方案比采用COG的1:3 MUX TDDI的成本上升6.5-9.5美元, 但是下边框尺寸极限可以由3.4-3.5mm缩减至2.3-2.5mm。
其次,在芯片封装方面,目前 COF 产能主要集中在中大尺寸, COG 集中在中小尺寸。要做全面屏模组厂需要重新投资中小尺寸的 COF bonding,产能缺口较大。同时,COF 封装需要超细 FPC 和高要 求的 bonding 工艺,成本也比 COG 要高。根据产业链调研情况,COF 单价比 COG 单价要高出 9 美金左右。 其中,全球 COF 制造企业能量产 10 微米等级的制造商,并且形 成规模化生产的主要为中国大陆以外的 5 家企业,分别为韩国的 Stemco 和 LGIT、台湾的欣邦和易华以及日本的新藤电子,Stemco、 LGIT 和新藤电子能做双面超细 COF 基板,欣邦和易华是单面的产能。

根据日本厂商目前可以做到的极限,使用 COF 下边框可以做到 2.5mm 以内,不过成本要比 COG 高出 9 美金左右,采用异形切割、 调整背光模组之后成本将会更高。其实,COG 经过优化下边框也能做窄,面对产能的限制、高昂的成本,手机品牌厂商真愿意为几毫米左 右的窄边框优势选择COF、进行异形切割设备投资、调整背光模组 么? 我们认为国产厂商今年更多的是采取一种折中方案,使用 COG 封装,将下边框做到 9mm 以下,最主要的是在整机尺寸不变的情况 下将之前的 5.2/5.5 寸屏升级为 5.7/6 寸,推出“低配版”全面屏。而 苹果等高端品牌机型的屏幕变革将进行的更加彻底一些,采用 COF 封装、增加异形切割工序等,努力将下边框收窄至 5mm 以下,这也是全面屏技术的长期选择。
COF相比COG是更优的解决方案
COF可以缩小下边框的长度,符合全面屏发展趋势。COF全称为Chip On FPC 或Chip On Film,中文为柔性基板上的芯片技术,与COG不同之处为,COF将芯片 直接封装到FPC上,由于FPC可以自由弯曲,因此可以将其折到玻璃背面,从而实 现缩小下边框的目的。与COG相比,其可以缩小边框大约1.5mm。
具体工艺上,COF分单层COF和双层COF。从整个生产上考量,单层COF和双 层COF两者均有其优点和缺点。简单来看,单层COF好处是价格便宜,一般比双层 便宜5倍,但缺点是需要极高的精准设备,一般机台无法达到COF的要求。双层COF 好处是可以达到更高的解析度,其缺点是需要打两层COF,成本高昂,需要更多的 Bonding设备。
MOB和MOC芯片封装技术:在封装环节推动前置CCM小型化,有望加速渗透 新型MOB和MOC封装技术相比传统的COB等封装方式能够减小模组尺寸。目前摄像头芯片封装有CSP(Chip Size Package)、COB(Chip On Board)、COF (Chip On FPC)和FC(Flip Chip)技术四种,随着手机摄像头像素越来越高,主要用于800万像素以下的CSP技术地位下降,能够实现更高图像质量的COB、COF/FC更受青睐。采用FC封装得到的模组会薄1mm,但成本也较高。但在全面屏趋势下,需要有新的技术将摄像头模组做的更小。

在传统的COB封装中,线路板上安装了感光芯片、连接线和电路器件(如电容、 电阻等),同时用一个底座(通常是一个塑料支架)粘贴于线路板上。芯片和电路器件都是裸露在空间中的,底座没有将芯片和电路元件包覆在内。 而在新型的MOB(Molding On Board)封装技术中,线路板部分包含线路板主 体和封装部,封装部通过模塑的方式与线路板一体化连接,取代了COB封装技术中 的塑料底座。MOB中线路板上依然有感光芯片、连接线和电路元件,不同于COB技术,MOB中封装部同时将电路元件(电容、电阻等)包覆在内,一方面防止电路器 件上的灰尘杂物污染芯片,另一方面增加了封装部向内设置的空间,从而减小摄像 头模组的宽度。在更进一步的MOC(Molding On Chip)封装技术中,封装部不仅将电路元件 包覆在内,还将连接线也包覆在内,并与一部分芯片连接。因此封装部向内设置的 空间更大,从而摄像头模组宽度减小的空间也更大。
COF方案所用的FPC主要采用聚酰亚胺(PI膜)混合物材料,厚度仅为50-100um,线宽线距在20um以下,所以在FPC生产过程中要采用半加成,或者加成法工艺。目前COF 封装用的FPC主要是台系厂商供货,如易华电等。而国内厂商如景旺电子,合力泰子公司蓝沛也有相关技术积累,后续有望受益于COF方案的进一步推广。 COF封装则是采用自动化的卷对卷设备生产。下图是典型的COF卷对卷生产流程示 意图,产线左右两边都是PI膜卷,PI膜通过自动封装机台从左往右传输,自动封装机 台下方会被持续加热至400摄氏度。芯片被压放在PI膜上之后,芯片下方的金球会和PI 膜中的引线键合,这一过程被称为内侧引线键合(ILB,Inner Lead Bonding),随后芯片会通过环氧树脂封装起来(Sealing Resin流程),并涂上阻焊层(Solder)进一 步保护IC,后续将其他周边元器件也通过ILB键合并封装在PI膜上。经过这一流程COF就生产完成了。由于COF卷对卷生产过程中需要加热,而PI膜的热膨胀系数为16um/m/C, 相比芯片的2.49 um/m/C而言,较为不稳定,所以对设备精度要求很高。
总体来说,随着手机显示屏分辨率需求的不断提升,在有限的显示区域内,COF封装技术面临着凸点节距变小、密度变高等技术难点与问题。不过OLED显示屏与LCD(液晶显示屏)在COF封装的实现工艺上有所不同,各厂商目前的设备精度与技术能力都很难以良好的可靠性和较高的良率来采用1-Layer COF来实现FHD规格以上的OLED显示屏,目前各家厂商都正积极研发解决方案,希望将来能将技术广泛应用于各种OLED面板设计。



















